钻孔时因加工热量使基板内树脂融化,附着于内层和外层铜箔之现象称之为胶渣。
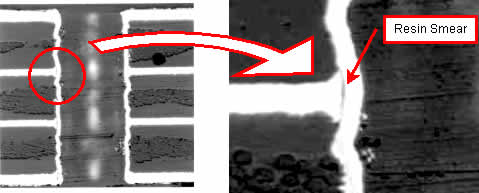
胶渣发生状态
| 异常原因 | 异常之状态 | 对策 |
|---|---|---|
| 使用ST形状钻头 | 与孔壁的接触面积增加致使加工温度上升 | 使用UC形状钻头 |
| 刃带宽过大 | 与孔壁的接触面積增加致使加工温度上升 | 设定适当的刃带宽 |
| 容屑沟之空间小 | 粉屑无法排出积在孔内,造成树脂附着与内层铜箔上 | 增大容屑沟之空间 |
| 异常原因 | 异常之状态 | 对策 |
|---|---|---|
| 再研磨品的钻尖端外周磨耗严重 | 因加工温度上升、易发生胶渣 | 确认磨耗状态 设定适当之再研磨量 |
| 异常原因 | 异常之状态 | 对策 |
|---|---|---|
| 进刀量太小 | 磨耗加剧、使加工温度上升而发生胶渣 | 进刀量太大 |
| 寿命设定(孔数)过多 |
| 异常原因 | 异常之状态 | 对策 |
|---|---|---|
| 基板Tg值过低 | 加工温度接近(或超过)TG值、发生胶渣 | 使用高Tg基板 |
| 高多层板等总铜箔厚度太厚 | 因切削阻抗过大、磨耗持续,使加工温度升高而引起胶渣 | 降低叠板数、孔数来减轻对钻头之负荷 使用套钻2次加工(Double drilling) |
| 异常原因 | 异常之状态 | 对策 |
|---|---|---|
| 没实施去胶渣处理 | 残留有钻孔所发生之胶渣 | 实施去胶渣处理 |